隨著半導體制程的不斷進步,集成電路的尺寸愈來愈小、芯片的集成密集度不斷提高,導致金屬互連線的寄生電阻效應和寄生電容效應愈來愈嚴重,進而使芯片的工作頻率無法再提升,這種情況稱之為阻容延時(又叫RC延時,RC Delay)。RC延時不僅阻礙工作頻率,同時也會增加電路功耗。

寄生電阻延遲的解決方案
寄生電阻的問題來自于線路本身的電阻性,使用電阻值更低、傳導性更佳的線路材質可以緩解寄生電阻延遲的問題。由于銅比鋁有更好的導電率,電阻較低,目前集成電路業界已經采用銅互連技術來代替鋁互連技術。
寄生電容延遲的解決方案
在集成電路內部,不同層互連線之間需要ILD(Inter Layer Dielectrics,層間電介質)來隔離并支撐。由于ILD的存在,導線之間就不可避免地存在寄生電容。使用低介電常數材料(low-k)作為ILD,可以有效地降低金屬互連線之間的寄生電容,從而提升芯片的穩定性和工作頻率。因此,Low-K工藝是目前集成電路的發展重點,特別是在邏輯運算,存儲等領域。
Low-k材料的加工方法
Low-K材料難以用普通的金剛石刀輪進行切割,原因是金剛石刀輪直接作用會導致Low-K材料的飛濺和外觀不良,如崩缺、裂紋、鈍化、金屬層掀起等現象。因此需先用激光去除硅晶圓表面的Low-K層,之后用刀輪切割硅等襯底材料。
目前主流的low-k層去除方式是使用激光開槽技術,通過光路系統將光斑整形成特定的形貌,將激光聚焦于材料表面達到特定槽型,并利用超快激光極高的峰值功率,將low-k層瞬間汽化,沒有中間過程,從而極大的減少熱影響區,是一種先進的激光“冷” 加工工藝制程。
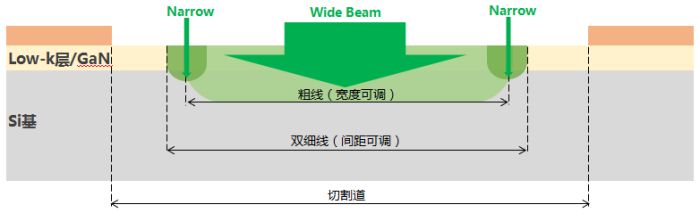
如上圖所示,激光加工Low-K開槽的加工方式是先用Dual narrow方式在切割道內部切兩條細保護槽(Trenching),再用Wide beam方式進行寬度開槽(Grooving)。
Low-k晶圓加工工藝流程
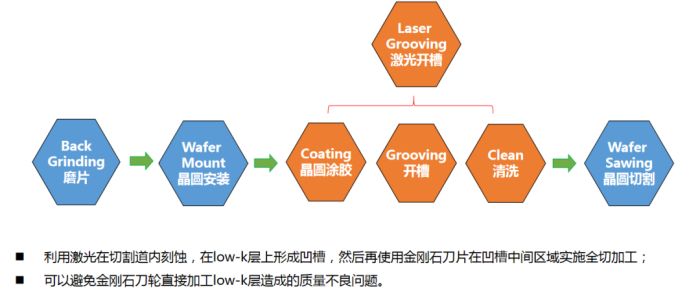
全自動晶圓激光開槽設備

大族半導體憑借在激光微加工領域的實踐經驗和理論基礎,于2018年在國內率先進行Low-K開槽關鍵技術的研發并取得突破性進展。同步研發推出紫外納秒加工方案,可以在保證槽型滿足需要的提前下,帶來更高的加工效率,陸續得到行業標桿客戶的高度認可。
應用領域
半導體激光開槽機是為半導體硅晶圓Low-K材料激光開槽設計,適用范圍拓展到金屬膜以及GaN/Si晶圓激光開槽、硅晶圓、鉭酸鋰晶圓以及氮化鎵晶圓切割等。
設備優勢
● 支持全自動、半自動功能,涂膠、切割任意工位抽檢,優化動作流程,保證效率始終最優;
● 可以實時監控所有Wafer以及整個系統流程及狀態;
● 開發的異常保護機制,保證異常時Wafer不被損壞;
● 定制大理石底座和高精度切割模塊,配合自研算法,實現穩定的微米級加工;
● 優化自動化上下料模塊,實現超薄片(≤80μm)穩定搬運。
主要參數及加工效果




大族半導體將結合公司雄厚的技術實力,秉持“創新驅動發展,制造崛起未來”的理念,深耕行業,緊隨市場,持續為半導體產業提供創新解決方案,努力實現半導體設備國產化。













 明基投影機
明基投影機 堅果投影機
堅果投影機 科視投影機
科視投影機 極米投影機
極米投影機 SONNOC投影機
SONNOC投影機 寶視來投影機
寶視來投影機 視美樂投影機
視美樂投影機 當貝投影機
當貝投影機 哈趣投影機
哈趣投影機 WAP手機版
WAP手機版 建議反饋
建議反饋 官方微博
官方微博 微信掃一掃
微信掃一掃 PjTime
PjTime